L’eccellenza della tecnica Broad Ion Beam (BIB) nella Failure Analysis dei Solder Bump Joints
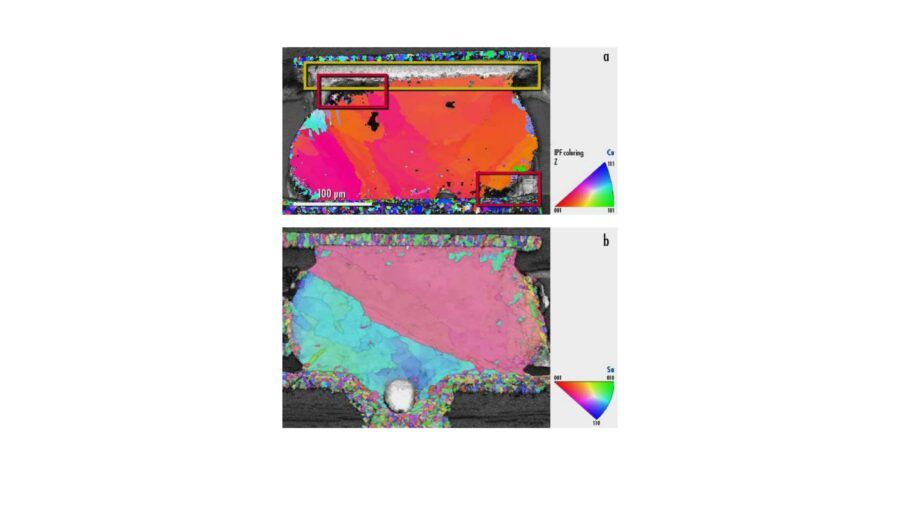
L’efficienza operativa dei sistemi microelettronici d’avanguardia dipende strettamente dalla qualità dei solder bump joints. Tali giunti non solo assicurano la continuità elettrica e meccanica tra chip e substrato, ma ne preservano l’integrità strutturale nel tempo.
Con il SEM si può fare! …Oppure no?

Avvicinarsi al Microscopio Elettronico a Scansione (SEM) può generare grandi aspettative nei nuovi utenti. Tuttavia, un approccio professionale e costruttivo inizia chiarendo subito cosa lo strumento non può fare, per poi esplorare le soluzioni tecniche che permettono di superare le barriere .
Posso vedere immagini a colori dei miei campioni?
Posso vedere gli atomi?
Posso guardare attraverso i diversi strati che compongono il mio campione?
Posso misurare le altezze delle rugosità sulle superfici?
Posso analizzare un campione immerso in un liquido?
E le microplastiche?
Leggi la nostra ultima application note per sapere cosa si può e cosa non si può fare con il SEM, e i nostri suggerimenti per andare oltre le limitazioni della microscopia elettronica.
Le cause del danneggiamento per fatica su scala sub-millimetrica
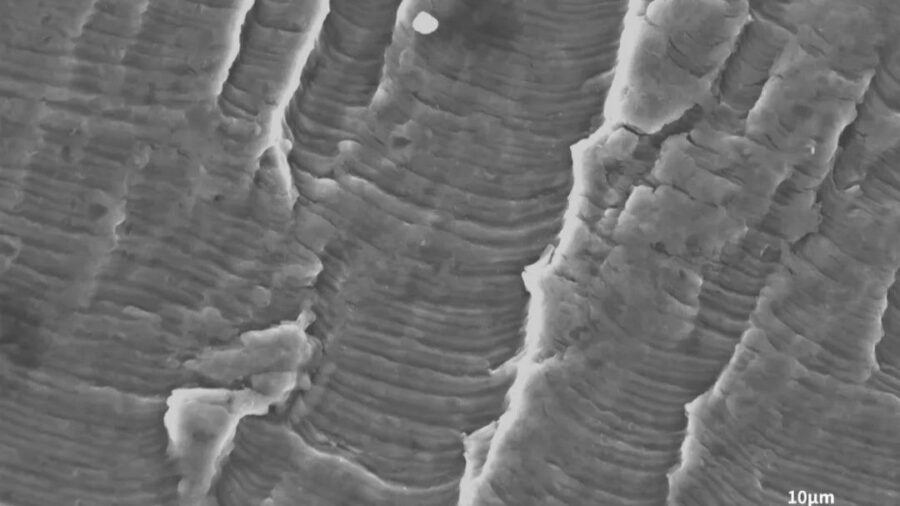
La fatica è un processo di degrado progressivo che interessa i materiali sottoposti a sollecitazioni cicliche, portando spesso a rotture anche al di sotto del limite elastico. Questo articolo approfondisce il fenomeno nei materiali metallici, analizzando l’effetto dei difetti interni, delle disomogeneità microstrutturali e delle dislocazioni cristalline. Grazie all’impiego di tecniche avanzate come SEM, EBSD e FIB-SEM, è possibile visualizzare la struttura interna del materiale e identificare le cause dell’innesco e della propagazione delle cricche. L’obiettivo è comprendere meglio il comportamento a fatica per migliorare l’affidabilità dei componenti meccanici.
NanoInnovation 2024

Il Congresso di microscopia elettronica italiano NanoInnovation 2024 si svolgerà a Roma dal 9 al 13 Settembre e Media System Lab ci sarà. Saremo presenti anche con uno dei nuovi SEM Ciqtek che sarà a disposizione di chiunque vorrà testarlo durante gli orari di apertura del Congresso ed è già possibile prenotare live demo chiamando […]
Electron Microscopy Congress 2024

Il Congresso di microscopia elettronica più importante d’Europa apre le porte e Media System Lab ci sarà. Nel Gennaio 2020 abbiamo partecipato a Copenhagen alla riunione per la presentazione agli espositori dell’EMC20 che si sarebbe dovuto tenere nell’Agosto dello stesso anno al centro congressi Bella Center ma la pandemia da SARS-COV-2 ha cambiato i piani […]
Presentazione esclusiva Oxford Nanoanalysis a Rovereto

Oxford Instruments, in collaborazione con Media System Lab, è lieta di invitarvi al primo workshop in Europa di presentazione del nuovo rivelatore “Unity”, in uscita a giugno 2023. Il sistema BEX (Backscatter Electron and X-ray) è una tecnologia innovativa che visualizza informazioni sulla composizione da raggi X caratteristici in parallelo con gli elettroni retrodiffusi, fornendo […]
Preparazione dei campioni per Solder Bump Joint Failure Analysis

La failure analysis al microscopio elettronico sui microgiunti di saldatura nei dispositivi elettronici è fondamentale per garantire l’affidabilità dei dispositivi stessi. La Broad Ion Beam Milling con ioni Argon è la tecnica di preparazione del campione ideale, perché non introduce deformazioni o modifiche strutturali, garantendo una corretta valutazione del campione. Scopri i vantaggi del #BIBmilling e come ottenere il campione perfetto per le tue analisi al #SEM, #EDS ed #EBSD. #semiconduttori #semiconductors #microelettronica #electronicdevice #failureanalysis #solderbump #solderjoint #ionmill #SEMmill #ionpolishing
